미국에 20조 들여 첨단 패키징 시설 검토하는 하이닉스
美 칩스법 발 맞춰 현지 패키징 추진해 보조금-고객사 확보
올해 어드밴스드 패키지 1억불 이상 매출 올릴 것 기대
작년 AVP 신사업 나선 삼성전자…”2.5D로 시장 선도한다”

(팝콘뉴스=문재호 기자) 반도체 업계가 반도체 초미세화를 통한 트랜지스터 집적도 증가가 기술적 한계에 다다르고 막대한 연구개발비가 투입됨에 따라 종합반도체 회사들은 후공정 패키징 기술에 주목하고 있다.
삼성전자와 SK하이닉스는 첨단 패키지 기술 고도화로 반도체 성능을 끌어올리겠다는 구상이다.
28일 관련업계에 따르면 SK하이닉스는 어플라이드 머티리얼즈, 램리서치, 앰코 테크놀로지스 등 글로벌 반도체 장비 제조사가 있는 미국에 공장을 지어 美 정부로부터 지원금을 받고 최첨단 반도체 장비 설비를 현지에서 수급해 공정에 발빠르게 도입한다는 구상이다.
SK하이닉스가 미국에 짓고자 하는 첨단 패키징 공장은 미국 상무부가 지난해 11월 반도체과학법의 일환으로 마련한 총 30억 달러(약 4조 원) 규모의 ‘전미 어드밴스드 패키징 제조 프로그램(NAPMP)의 취지와도 부합해 지원금 수혜에 대한 기대감이 높다.
이 프로그램은 미국 내에서 어드밴스드 패키징 시설을 짓고 관련 인력 자원을 고용하는 기업에 지원금을 주기 위해 마련됐다.
앞서 SK하이닉스는 지난 2022년 미국 첨단 패키징 공장에 150억 달러(약 20조 원)을 투자를 밝힌 바 있다.
관련업계에서는 SK하이닉스가 아직 공장 부지를 확정하지 않은 요인 중 하나로 미국 정부와 보조금 지급 여부와 규모를 놓고 줄다리기를 하는 것으로 보고 있다.
SK하이닉스 관계자는 “(미국 패키징 투자에 대해) 검토 중이나 확정된 바는 없다”고 말했다.
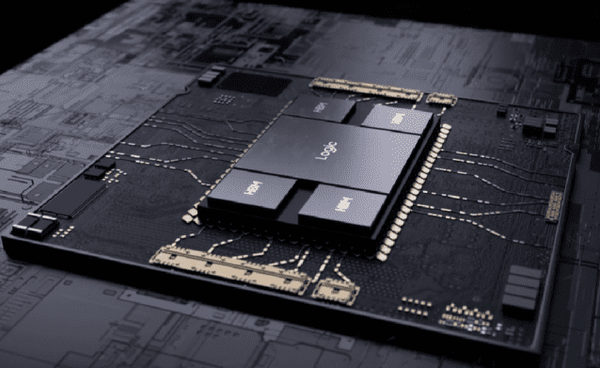
삼성전자도 어드밴스드 패키지 사업을 통해 종합 반도체 리딩 기업으로 반도체 산업 생태계를 이끌어 간다는 전략이다.
경계현 삼성전자 사장은 최근 열린 주주총회에서 “지난해 시작한 어드밴스드 패키지 사업을 통해 올해 2.5D(차원) 패키징 제품으로 1억 달러 이상 매출을 올릴 것으로 예상된다”며 “2.xD, 3.xD, 패널 레벨 등 업계가 필요로 하는 기술을 고객과 함께 개발해 사업을 성장시킬 계획”이라고 포부를 밝혔다.
2.5D 패키징은 중앙에 연산을 담당하는 로직 반도체를 놓고 주변에 고대역폭메모리(HBM) 등을 배치·상호 연결하는데 필수인 기술이다.
기판(웨이퍼)만을 활용하는 기존 2D 패키징에 비해 회로를 더 밀도 있게 연결할 수 있어, AI 가속기나 고성능컴퓨팅(HPC) 구현에 유리하다.
시장조사기관에 따르면 첨단 패키지 시장은 2021년부터 2027년까지 연평균 9.6%의 고성장을 기록할 것으로 예상된다.
특히 이종집적 기술을 사용한 2.5차원, 3차원 패키지의 경우 매년 14% 이상 성장해 전체 첨단 패키지 시장을 상회할 것으로 전망된다.
앞서 삼성전자는 이러한 추세에 발 맞춰 2022년 12월 첨단 패키지(Advanced Package, AVP) 사업팀을 신설해 대응 중이다.
삼성전자는 “AVP사업팀이 고객이 원하는 고성능·저전력 솔루션을 원스톱으로 제공하는 첨단 패키지 사업 모델을 가지고 있다”며 “재배선(RDL), 실리콘 인터포저/브릿지, 실리콘 관통 전극(TSV) 적층 기술 기반의 차세대 2.5차원, 3차원 첨단 패키지 솔루션을 집중 개발하고 있다”고 강조했다.
삼성전자 관계자는 “종합반도체 회사로서 반도체 제작부터 후공정에 이르는 패키징까지 고객 맞춤형으로 공급할 수 있다는 강점이 있다”며 “고객사가 삼성전자에 GPU 칩 양산을 의뢰하면 파운드리에서 제품을 만들고 난 뒤 2.5차원 또는 3차원으로 패키징해 고객에게 납품할 수 있다”고 말했다. [팝콘뉴스]

